SMT nggunakake tempel solder konvensional analisis rongga welding reflow lan solusi (2023 Essence Edition), sampeyan pantes!
1 Pambuka

Ing perakitan papan sirkuit, tempel solder dicithak ing papan solder papan sirkuit dhisik, banjur macem-macem komponen elektronik ditempelake. Pungkasan, sawise tungku reflow, manik-manik timah ing tempel solder dilebur lan kabeh jinis komponen elektronik lan pad solder saka papan sirkuit dilas bebarengan kanggo mujudake perakitan submodules listrik. surfacemounttechnology (sMT) tambah akeh digunakake ing produk packaging dhuwur Kapadhetan, kayata paket tingkat sistem (siP), ballgridarray (BGA) piranti, lan daya Bare Chip, kothak warata paket pin-kurang (quad aatNo-lead, diarani minangka QFN) piranti.
Amarga karakteristik saka proses welding tempel solder lan bahan, sawise welding reflow saka piranti lumahing solder gedhe iki, bakal ana bolongan ing wilayah welding solder, kang bakal mengaruhi sifat electrical, termal lan mechanical saka Performance produk, lan malah mimpin kanggo Gagal produk, mulane, kanggo nambah solder tempel reflow welding growong wis dadi proses lan masalah technical sing kudu ditanggulangi, lan sawetara peneliti wis analisa lan analisa werni BGA. kasedhiya solusi dandan, conventional tempel solder reflow welding proses welding area QFN luwih saka 10mm2 utawa welding area luwih saka 6 mm2 solusi chip gundhul kurang.
Gunakake welding Preformsolder lan welding tungku refluks vakum kanggo nambah bolongan weld. Solder prefabricated mbutuhake peralatan khusus kanggo titik fluks. Contone, chip diimbangi lan diiringake kanthi serius sawise chip diselehake langsung ing solder prefabrikasi. Yen flux gunung chip punika reflow lan banjur titik, proses tambah dening loro reflow, lan biaya prefabricated solder lan bahan flux luwih dhuwur tinimbang tempel solder.
Peralatan vakum refluks luwih larang, kapasitas vakum saka kamar vakum sawijining banget kurang, kinerja biaya ora dhuwur, lan masalah splashing timah serius, kang minangka faktor penting ing aplikasi saka dhuwur-Kapadhetan lan cilik-nada produk. Ing makalah iki, adhedhasar proses welding reflow tempel solder konvensional, proses welding reflow sekunder anyar dikembangake lan dikenalake kanggo nambah rongga las lan ngatasi masalah ikatan lan retak segel plastik sing disebabake dening rongga las.
2 Solder tempel printing reflow welding growong lan mekanisme produksi
2.1 Welding rongga
Sawise welding reflow, produk dites ing x-ray. Bolongan ing zona welding kanthi werna sing luwih entheng ditemokake amarga solder ora cukup ing lapisan welding, kaya sing dituduhake ing Gambar 1.
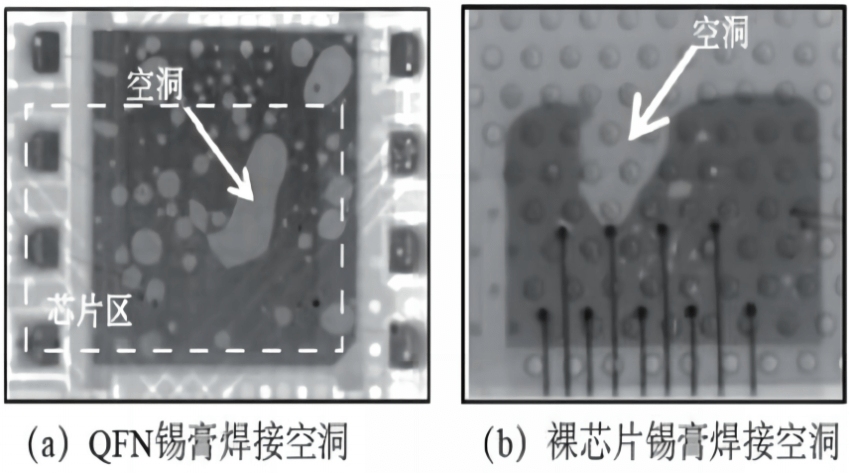
Deteksi sinar-X saka bolongan gelembung
2.2 Mekanisme pembentukan rongga las
Njupuk tempel solder sAC305 minangka conto, komposisi lan fungsi utama ditampilake ing Tabel 1. Manik-manik fluks lan timah digabungake ing wangun tempel. Rasio bobot saka solder timah kanggo fluks kira-kira 9: 1, lan rasio volume kira-kira 1: 1.

Sawise tempel solder dicithak lan dipasang karo macem-macem komponen elektronik, tempel solder bakal ngalami patang tahap preheating, aktivasi, refluks lan pendinginan nalika ngliwati tungku refluks. Kahanan tempel solder uga beda karo suhu sing beda-beda ing tahapan sing beda, kaya sing dituduhake ing Gambar 2.
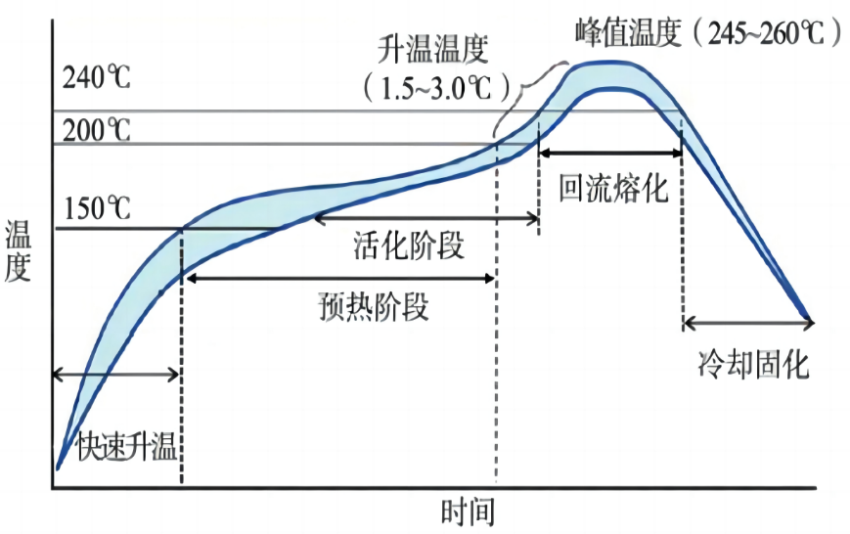
Referensi profil kanggo saben area solder reflow
Ing tataran preheating lan aktivasi, komponen molah malih ing flux ing tempel solder bakal volatilized dadi gas nalika digawe panas. Ing wektu sing padha, gas bakal diprodhuksi nalika oksida ing permukaan lapisan welding dibusak. Sawetara gas iki bakal volatilize lan ninggalake tempel solder, lan manik-manik solder bakal tightly condensed amarga volatilization saka flux. Ing tataran refluks, flux isih ing tempel solder bakal nguap cepet, manik-manik timah bakal nyawiji, jumlah cilik saka flux gas molah malih lan paling saka udhara antarane manik-manik timah ora bakal buyar ing wektu, lan ampas ing timah molten lan ing tension saka timah molten sing hamburger struktur sandwich lan kejiret dening Papan sirkuit elektronik, lan kejiret dening Papan sirkuit elektronik. uwal mung dening buoyancy munggah Wektu leleh ndhuwur banget cendhak. Nalika timah molten adhem lan dadi timah padhet, pori-pori katon ing lapisan las lan bolongan solder dibentuk, kaya sing ditampilake ing Gambar 3.
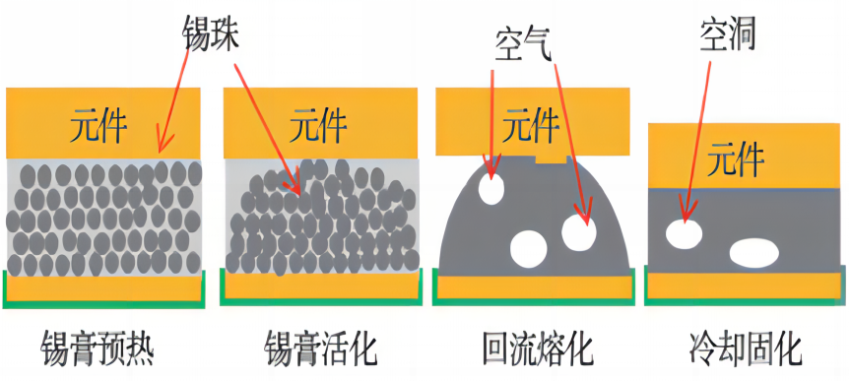
Diagram skematis saka kekosongan sing diasilake dening welding reflow paste solder
Penyebab utama rongga las yaiku hawa utawa gas molah malih sing dibungkus ing tempel solder sawise leleh ora rampung dibuwang. Faktor sing mengaruhi kalebu materi tempel solder, wangun printing tempel solder, jumlah cetakan tempel solder, suhu refluks, wektu refluks, ukuran welding, struktur lan liya-liyane.
3. Verifikasi faktor pengaruh saka solder tempel printing bolongan welding reflow
QFN lan tes chip gundhul digunakake kanggo konfirmasi nimbulaké utama voids welding reflow, lan golek cara kanggo nambah voids welding reflow dicithak dening tempel solder. QFN lan gundhul chip solder tempel profil produk welding reflow ditampilake ing Figure 4, QFN ukuran lumahing welding punika 4.4mmx4.1mm, lumahing welding lapisan tinned (100% timah murni); Ukuran welding chip gundhul punika 3.0mmx2.3mm, lapisan welding sputtered nikel-vanadium lapisan bimetallic, lan lapisan lumahing punika vanadium. Welding pad saka landasan ana electroless nikel-paladium emas-dipping, lan kekandelan ana 0.4μm/0.06μm/0.04μm. Tempel solder SAC305 digunakake, peralatan cetak tempel solder yaiku DEK Horizon APix, peralatan tungku refluks yaiku BTUPyramax150N, lan peralatan x-ray yaiku DAGExD7500VR.
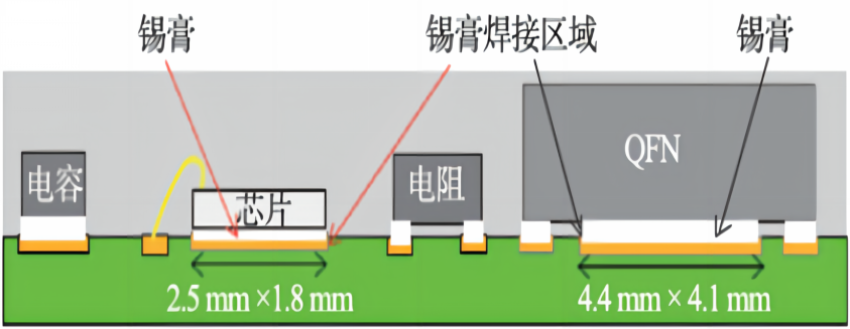
QFN lan gambar welding chip gundhul
Kanggo nggampangake mbandhingake asil tes, welding reflow ditindakake miturut kondisi ing Tabel 2.

Tabel kondisi las reflow
Sawise lumahing soyo tambah lan welding reflow rampung, lapisan welding dideteksi dening X-ray, lan ketemu sing ana bolongan gedhe ing lapisan welding ing ngisor QFN lan chip gundhul, minangka ditampilake ing Figure 5.
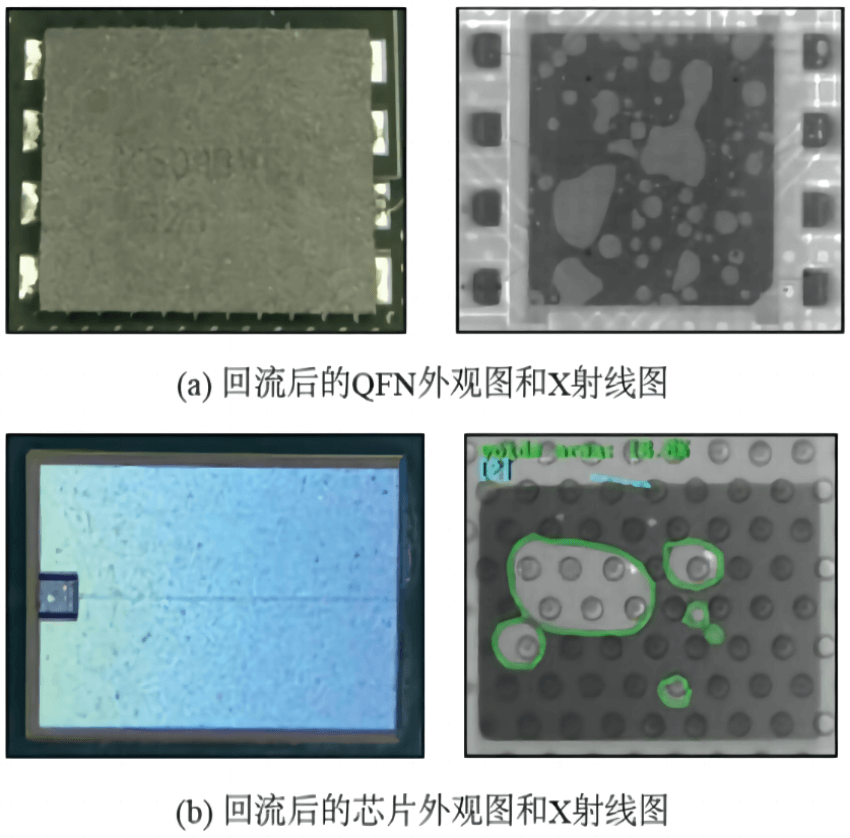
QFN lan Chip Hologram (X-ray)
Wiwit ukuran manik timah, kekandelan bolong baja, tingkat area bukaan, wangun bolong baja, wektu refluks lan suhu tungku puncak kabeh bakal mengaruhi voids welding reflow, ana akeh faktor pengaruhe, kang bakal langsung diverifikasi dening test DOE, lan nomer klompok eksperimen bakal gedhe banget. Sampeyan kudu cepet layar lan nemtokake faktor pengaruh utama liwat test comparison korélasi, lan banjur luwih ngoptimalake faktor pengaruh utama liwat DOE.
3.1 Ukuran bolongan solder lan manik-manik timah tempel solder
Kanthi tes pasta solder tipe3 (ukuran manik 25-45 μm) SAC305, kondisi liyane tetep ora owah. Sawise reflow, bolongan ing lapisan solder diukur lan dibandhingake karo pasta solder type4. Ditemokake yen bolongan ing lapisan solder ora beda banget ing antarane rong jinis tempel solder, nuduhake yen tempel solder kanthi ukuran manik sing beda-beda ora duwe pengaruh sing jelas ing bolongan ing lapisan solder, sing ora dadi faktor pengaruh, kaya sing dituduhake ing FIG. 6 Kaya sing dituduhake.

Perbandingan bolongan bubuk timah metalik kanthi ukuran partikel sing beda
3.2 Ketebalan rongga las lan bolong baja sing dicithak
Sawise reflow, area rongga lapisan sing dilas diukur nganggo bolong baja sing dicithak kanthi kekandelan 50 μm, 100 μm lan 125 μm, lan kondisi liyane tetep ora owah. Ditemokake yen efek saka macem-macem kekandelan bolong baja (solder paste) ing QFN dibandhingake karo bolong baja dicithak kanthi kekandelan 75 μm Minangka kekandelan bolong baja mundhak, area growong mboko sithik sudo. Sawise sik njongko kekandelan tartamtu (100μm), wilayah growong bakal mbalikke lan wiwiti nambah karo nambah saka kekandelan bolong baja, minangka ditampilake ing Figure 7.
Iki nuduhake yen jumlah tempel solder tambah, timah Cairan karo refluks ditutupi dening chip, lan stopkontak uwal online ampas mung sempit ing papat sisih. Nalika jumlah tempel solder diganti, stopkontak saka uwal online ampas uga tambah, lan bledosan cepet saka online kebungkus timah Cairan utawa gas molah malih uwal timah Cairan bakal nimbulaké Cairan timah cipratan watara QFN lan chip.
Tes kasebut nemokake manawa kanthi nambah kekandelan bolong baja, gelembung bledosan sing disebabake dening uwal saka udara utawa gas molah malih uga bakal nambah, lan kemungkinan timah splashing watara QFN lan chip uga bakal nambah cocog.

Perbandingan bolongan ing bolong baja kanthi ketebalan sing beda
3.3 Rasio area rongga las lan bukaan bolong baja
Bolong baja sing dicithak kanthi tingkat bukaan 100%, 90% lan 80% diuji, lan kondisi liyane tetep ora owah. Sawise reflow, area rongga lapisan sing dilas diukur lan dibandhingake karo bolong baja sing dicithak kanthi tingkat bukaan 100%. Ditemokake yen ora ana bedane sing signifikan ing rongga lapisan sing dilas ing kondisi tingkat bukaan 100% lan 90% 80%, kaya sing ditampilake ing Gambar 8.

Perbandingan rongga saka area bukaan sing beda saka bolong baja sing beda
3.4 Rongga las lan wangun bolong baja dicithak
Kanthi test wangun printing saka tempel solder saka Strip b lan kothak c, kahanan liyane tetep panggah. Sawise reflow, area rongga saka lapisan welding diukur lan dibandhingake karo wangun printing kothak a. Ditemokake ora ana prabédan sing signifikan ing rongga lapisan welding ing kondisi kothak, strip lan kothak miring, kaya sing dituduhake ing Gambar 9.
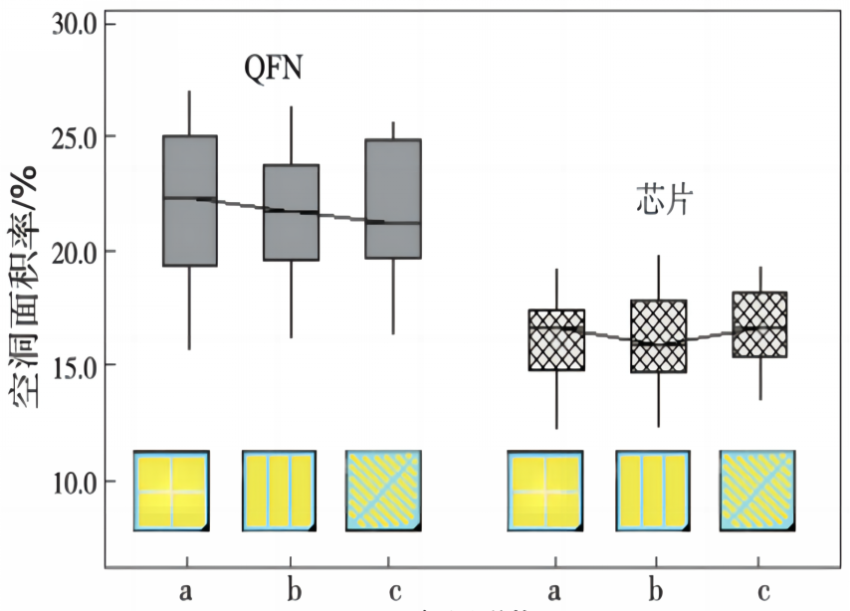
Perbandingan bolongan ing macem-macem mode bukaan bolong baja
3.5 Welding growong lan wektu refluks
Sawise tes wektu refluks sing dawa (70 s, 80 s, 90 s), kahanan liyane tetep ora owah, bolongan ing lapisan welding diukur sawise refluks, lan dibandhingake karo wektu refluks 60 s, ditemokake yen kanthi nambah wektu refluks, area bolongan las mudhun, nanging amplitudo pengurangan ing Figur iki suda kanthi bertahap. Ing kasus wektu refluks ora cukup, nambah wektu refluks kondusif kanggo kebanjiran kebak online kebungkus timah Cairan molten, nanging sawise wektu refluks mundhak kanggo wektu tartamtu, online kebungkus timah Cairan angel kanggo overflow maneh. Wektu refluks minangka salah sawijining faktor sing mengaruhi rongga las.

Perbandingan ora sah saka macem-macem wektu refluks
3.6 Welding growong lan suhu tungku puncak
Kanthi tes suhu tungku puncak 240 ℃ lan 250 ℃ lan kahanan liyane sing ora owah, area rongga lapisan sing dilas diukur sawise reflow, lan dibandhingake karo suhu tungku puncak 260 ℃, ditemokake yen ing kondisi suhu tungku puncak sing beda-beda, rongga lapisan sing dilas saka QFN lan chip ora katon beda, kaya sing dituduhake ing 1. suhu pawon wis ora efek ketok ing QFN lan bolongan ing lapisan welding chip, kang ora faktor mengaruhi.

Perbandingan roso sepi suhu puncak sing beda
Tes ing ndhuwur nuduhake yen faktor penting sing mengaruhi rongga lapisan las saka QFN lan chip yaiku wektu refluks lan ketebalan bolong baja.
4 Solder tempel printing reflow welding rongga dandan
4.1 Tes DOE kanggo nambah rongga welding
Bolongan ing lapisan welding QFN lan chip iki apik dening nemokake Nilai optimal saka faktor pengaruh utama (wektu refluks lan kekandelan bolong baja). Tempel solder yaiku SAC305 type4, bentuk bolong baja yaiku jinis kothak (derajat bukaan 100%), suhu tungku puncak 260 ℃, lan kahanan tes liyane padha karo peralatan uji. Test DOE lan asil ditampilake ing Tabel 3. Pengaruh saka kekandelan bolong baja lan wektu refluks ing QFN lan chip welding bolongan ditampilake ing Figure 12. Liwat analisis interaksi faktor pengaruh utama, Ditemokake yen nggunakake 100 μm bolong baja kekandelan lan wektu refluks 80 s bisa Ngartekno nyuda growong welding saka QFN lan chip. Ing tingkat growong welding saka QFN wis suda saka maksimum 27,8% kanggo 16,1%, lan tingkat growong welding chip suda saka maksimum 20,5% kanggo 14,5%.
Ing test, 1000 produk diprodhuksi ing kondisi optimal (100 μm baja bolong kekandelan, 80 s wektu refluks), lan tingkat growong welding 100 QFN lan chip diukur kanthi acak. Tingkat rongga las rata-rata QFN yaiku 16,4%, lan tingkat rongga las rata-rata chip yaiku 14,7% Tingkat rongga las saka chip lan chip temenan suda.

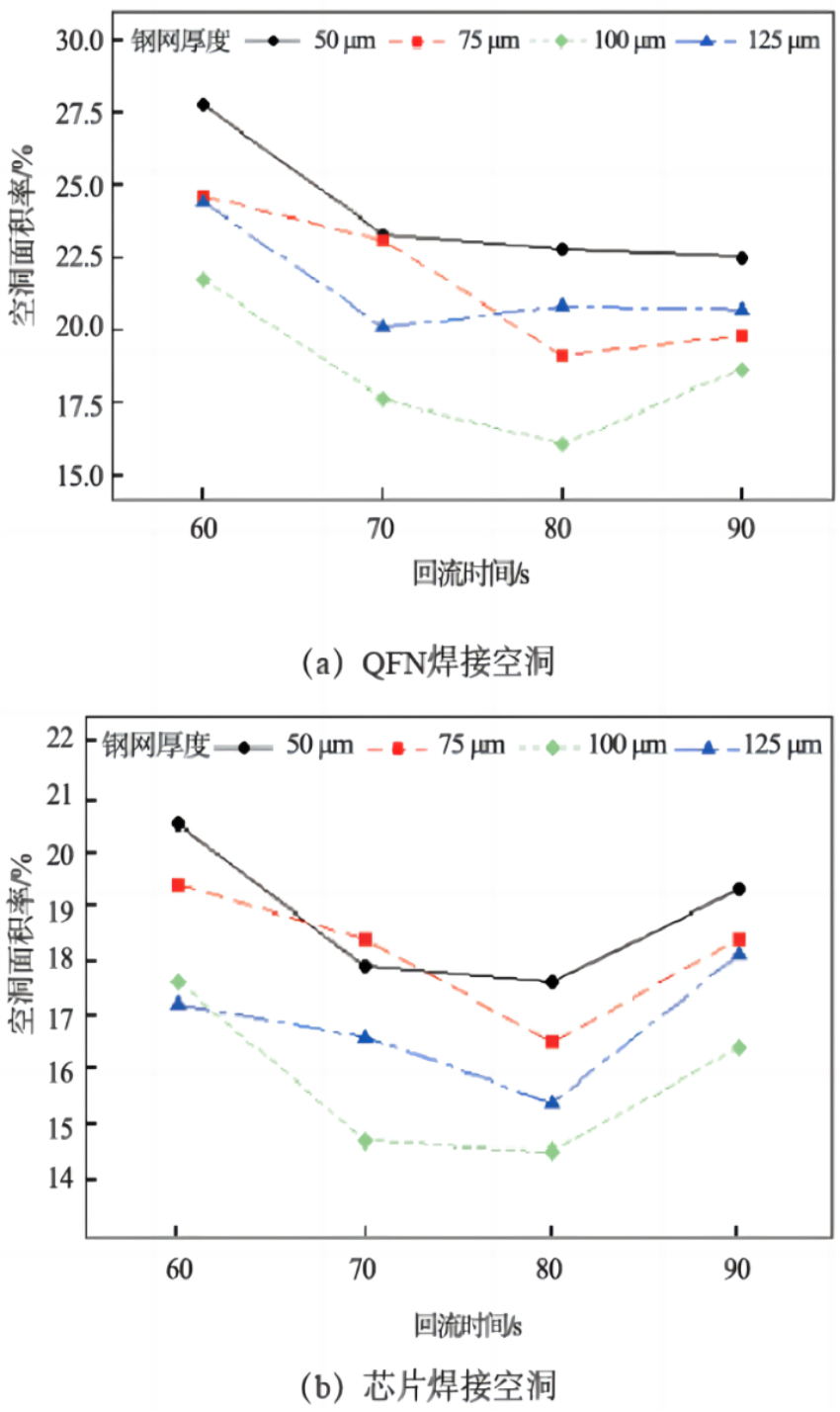
4.2 Proses anyar mbenakake rongga welding
Kahanan produksi nyata lan tes nuduhake yen area growong welding ing ngisor chip kurang saka 10%, masalah retak posisi growong chip ora bakal kelakon sak iketan timbal lan ngecor. Parameter proses sing dioptimalake dening DOE ora bisa nyukupi syarat nganalisa lan ngrampungake bolongan ing welding reflow tempel solder konvensional, lan tingkat area rongga las chip kudu dikurangi.
Wiwit chip dijamin ing solder ngalangi gas ing solder saka uwal, tingkat bolongan ing ngisor chip luwih suda dening ngilangke utawa ngurangi gas ditutupi solder. A proses anyar welding reflow karo loro printing tempel solder diadopsi: siji printing tempel solder, siji reflow ora nutupi QFN lan chip gundhul discharging gas ing solder; Proses tartamtu saka printing tempel solder sekunder, tambalan lan refluks sekunder ditampilake ing Gambar 13.
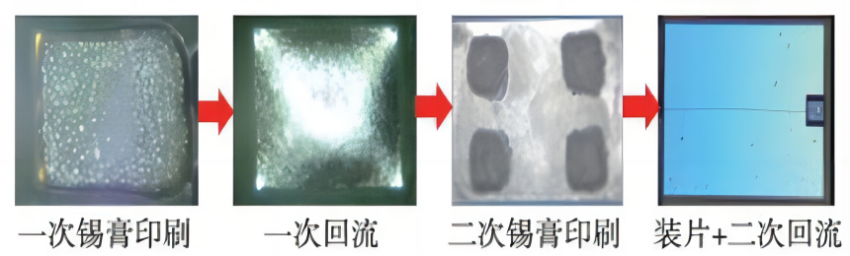
Nalika tempel solder nglukis 75μm dicithak kanggo pisanan, umume gas ing solder tanpa tutup chip oncat saka permukaan, lan kekandelan sawise refluks kira-kira 50μm. Sawise rampung refluks utami, kothak cilik dicithak ing permukaan solder solidified sing wis adhem (supaya nyuda jumlah tempel solder, nyuda jumlah tumpahan gas, nyuda utawa ngilangi spatter solder), lan tempel solder kanthi kekandelan 50 μm (asil tes ing ndhuwur nuduhake yen 100 μm paling apik, saéngga kekandelan cetak sekunder 100μm = 50μm. μm), banjur instal chip, banjur bali liwat 80 s. Ana meh ora bolongan ing solder sawise printing pisanan lan reflow, lan tempel solder ing printing kapindho cilik, lan bolongan welding cilik, minangka ditampilake ing Figure 14.
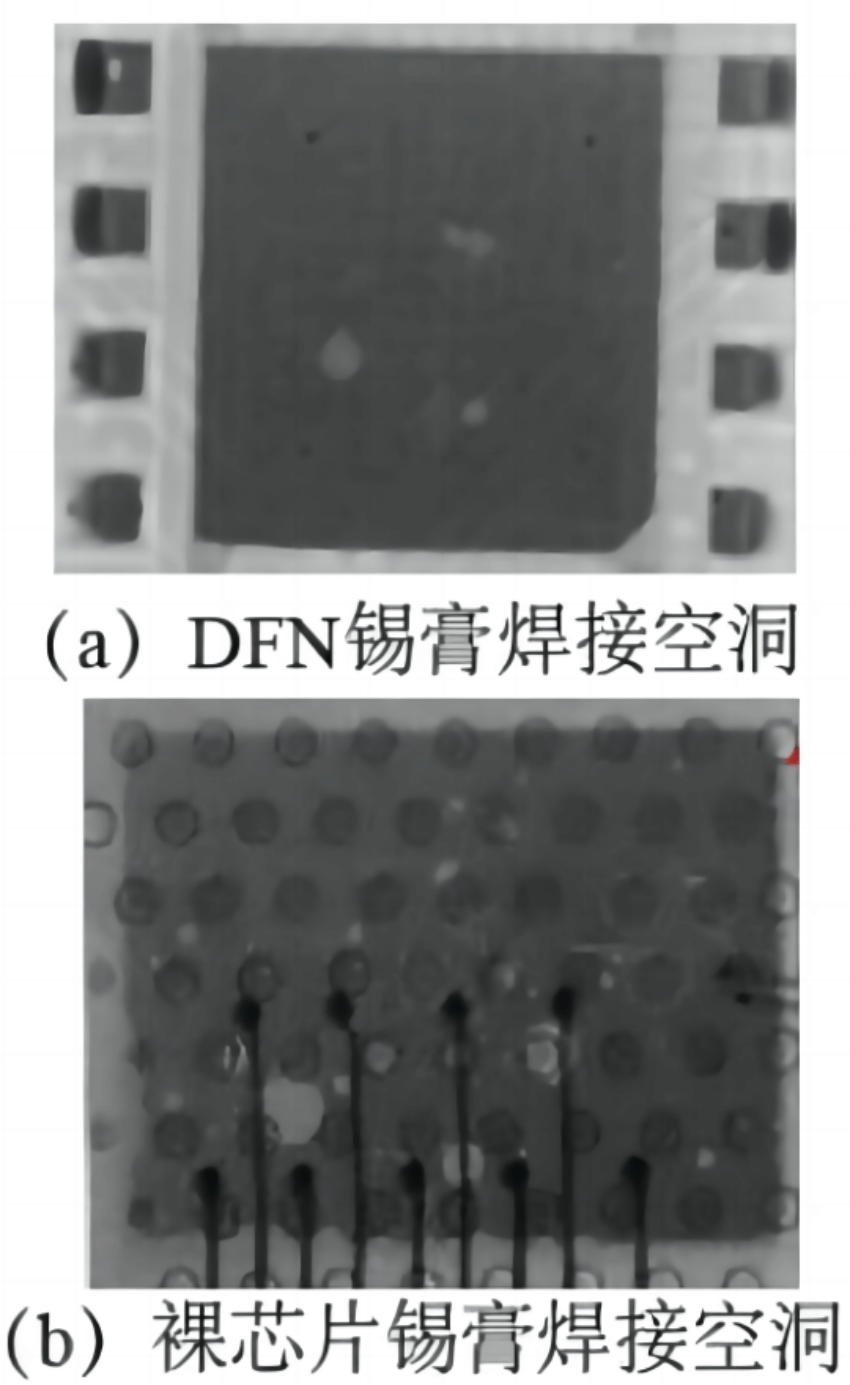
Sawise rong printing tempel solder, gambar kothong
4.3 Verifikasi efek rongga welding
Produksi 2000 produk (kekandelan saka bolong baja printing pisanan 75 μm, kekandelan saka bolong baja printing kapindho 50 μm), kahanan liyane ora owah, ukuran acak saka 500 QFN lan chip welding tingkat growong, ketemu sing proses anyar sawise refluks pisanan ora growong, sawise welding tingkat maksimum QFN 8. tingkat growong chip punika 4,1%. Dibandhingake karo proses welding printing siji-tempel asli lan proses DOE optimized, growong welding wis suda Ngartekno, minangka ditampilake ing Figure 15. Ora ana retak chip ditemokaké sawise tes fungsi kabeh produk.

5 Ringkesan
Optimisasi jumlah printing tempel solder lan wektu refluks bisa nyuda area rongga las, nanging tingkat rongga las isih gedhe. Nggunakake rong teknik pengelasan reflow printing solder kanthi efektif lan nggedhekake tingkat rongga las. Welding area saka QFN sirkuit chip Bare bisa 4.4mm x4.1mm lan 3.0mm x2.3mm mungguh ing produksi massa Tingkat growong saka welding reflow kontrol ngisor 5%, kang mbenakake kualitas lan linuwih welding reflow. Panliten ing kertas iki menehi referensi penting kanggo nambah masalah growong welding lumahing welding area gedhe.






